La-FMD ALD predhodnik za prihodnje vrhunske logične in pomnilniške izdelke
Elementi redkih zemelj so vstopili v velikoserijsko proizvodnjo za napredne logične naprave od 32 nm vozlišča (IBM, Samsung in Globalfoundries – Chipworks 2010). Zlasti za lantan (La) - eponim serije lantanidov v periodnem sistemu je bil implementiran kot dopant v nizu kovinskih vrat z visokim K. Lantanov oksid (La2O3, dielektrična konstanta ~ 27), so na primer že dve desetletji raziskovali kot dielektrik z vrati z visokim K za zamenjavo običajnega silicijevega dioksida (SiO2) vratni dielektrik v tranzistorjih naslednje generacije v logiki kot tudi v dinamičnih pomnilnikih z naključnim dostopom (DRAM).

Segmentacija patentnih prijav po ključnih besedah v zadnjih 20 letih za lantan in"Atomic Layer Deposition" [iskanje v Patbase 15. novembra 2018]
Atomsko plastno nanašanje je najbolj obetavna metoda za gojenje ultratankih filmov dielektrikov z vrati na osnovi La in je bila zato predmet obsežnih raziskav in vložitve patentnih prijav v zadnjih 20 letih. Prizadevanja za raziskave in razvoj so bila osredotočena na področja, povezana z dielektričnimi in visoko-k dielektričnimi aplikacijami v industriji polprevodnikov (glejte segmentacijo ključnih besed zgoraj). Atomska rast filma plast za plastjo, ki jo olajšajo samoomejevalne površinske reakcije v ALD, zagotavlja atomsko natančen nadzor debeline filma, dobro enakomernost po velikem substratu in odlično konformalnost v primeru struktur z visokim razmerjem stranic, kot so sodobni FinFET in pomnilniški kondenzator tip stebričastih konstrukcij. Vendar pa za brezhibno delovanje potrebuje prekurzorje ALD, ki imajo posebne lastnosti (POVEZAVA):
1. Dovolj hlapni (vsaj ~ 0,1 Torr ravnotežnega parnega tlaka pri temperaturi, pri kateri se toplotno ne razgradijo).
2. Hitro izhlapevanje in s ponovljivo hitrostjo (pogoji, ki so običajno izpolnjeni za tekoče predhodne sestavine, ne pa tudi za trdne snovi).
3. Ne reagirajo sami ali se razgradijo na površini ali v plinski fazi (za samoprekinitvene površinske reakcije).
4. Zelo reaktiven z drugim reaktantom, ki je bil predhodno pritrjen na površino, kar ima za posledico relativno hitro kinetiko in s tem nižje temperature ALD in čase ciklov.
5. Hlapni stranski produkti, ki jih je mogoče zlahka očistiti, da se pripravijo na naslednji pol-cikel.
6. Nekorozivni stranski proizvodi za preprečevanje neenotnosti zaradi jedkanja filma in korozije orodja.
Leta 2007 je Intel Corporation vključila HfO2v visoko-k gate dielektrični sklad na 45 nm tehnološkem vozlišču. Vendar čisti HfO2ima težave z vmesniškim slojem z nizko vsebnostjo k s Si, kar omejuje nižje vrednosti ekvivalentne debeline oksida (EOT). Prav tako zlahka kristalizira pri temperaturah do ~500 stopinj. Zato so amorfni dielektriki z visoko toplotno stabilnostjo še vedno iskani, ker nimajo notranjih napak (npr. meja zrn), pod pogojem, da še vedno nudijo prednosti HfO2, kot so visoka dielektrična konstanta, širok razpon in nizek tok uhajanja. Ternarni oksidi na osnovi lantana, kot je lantanov skandat (LaScO3) in lantanov lutecijev oksid (LaLuO3), odložen s postopkom ALD, ki vključuje prekurzorje kovinskih amidinatov, naj bi imel zaželene strukturne in električne lastnosti. Pravzaprav LaLuO3je potencialno najboljši dielektrik z amorfnimi faznimi vrati z dielektrično konstanto k~32. S Si ne tvori medfaznih plasti z nizko vsebnostjo k, kar omogoča vrednosti efektivne debeline oksida (EOT) < 1 nm s precej nizkim tokom uhajanja. Še en dejavnik, ki prispeva k nizkemu uhajalnemu toku preko ALD, je bil tanjši LaLuO3dielektrik vrat je velik pasovni odmik (2,1 eV) glede na Si; simetrična prevodnost in odmiki valenčnega pasu povzročijo enake uhajajoče tokove v NMOSFET-jih, ki jih poganjajo elektroni, in PMOSFET-jih, ki jih poganjajo luknje. Ostaja amorfen in ne tvori zlitin s Si ali Ge po ustreznih izvorno/odvodnih aktivacijskih žarjenjih.

Kot zelo nedavni primer dejanske uporabe visokega razmerja stranic na 300 mm rezinah, ki zahteva vse značilnosti prekurzorja ALD, opisane zgoraj (1 do 6), si lahko ogledamo članek, ki ga je Imec predstavil na tej slavni konferenci IEDM, o uporabi plasti LaSiOx kot dipola vstavljen v sklad HKMG. Imec je uspel zložiti celoten sprednji modul FinFET na vrh "standardnega" masivnega silicijevega modula FinFET, ki je pokazal tudi dobro nastavitev napetosti praga, zanesljivost in delovanje pri nizkih temperaturah. Verjetno je bil najverjetneje odložen s postopkom ALD, saj bo moral konformno prevleči rebra in zagotoviti natančen nadzor debeline in enakomernost: IEDM2018 Paper #7.1, "Prva predstavitev 3D zloženih FinFET-jev pri 45 nm koraku rebri in tehnologiji koraka vrat 110 nm na 300 mm rezinah," A. Vandooren et al, Imec.
Tako kot v tem primeru in mnogih drugih jih stroge kvalifikacije za predhodne sestavine ALD uvrščajo v kategorijo visokokakovostnih posebnih kemikalij – izbrani materiali ali molekule, specifične za učinkovitost ali funkcijo. Na lastnosti nanesenega filma močno vplivajo fizikalne in kemijske lastnosti posamezne molekule ali formulirane mešanice molekul ter njena kemična sestava. Zato predstavlja velik pritisk na proizvajalca in dobavitelja posebnih kemikalij visoke čistosti v smislu kakovosti, čistosti, dokumentacijskih postopkov, storitev za stranke itd.
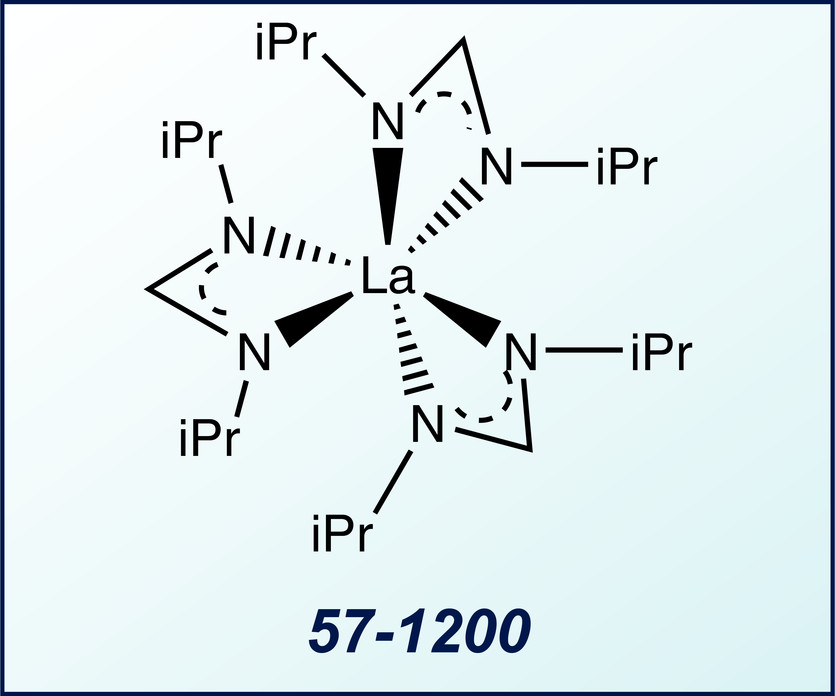
Tris(N,N'-di-i-propilformamidinato)lantan(III), (99.999+%-La) La-FMD je eden od prekurzorjev kovinskih amidinatov za La ALD. Material je bel do umazano bel prah. Kemijska formula in molekulska masa La-FMD sta C21H45LaN6oziroma 520,53. Podjetje Rohm and Haas Electronic Materials LLC (pozneje Dow Chemical) poroča o La-FMD kot najbolj hlapljivem predhodniku La, znanem doslej. Parni tlak pri dani temperaturi, ki ga posreduje La-FMD, je višji od tlaka La(Cp)3in La(thd)3. Poleg tega Roy G. Gordon z univerze Harvard poroča, da so amidinatni prekurzorji termično bolj stabilni kot njihovi amidni dvojniki zaradi kelatnega amidinatnega liganda in odsotnosti MC vezi. La amidinati so zelo reaktivni z vezmi Si-H, kar povzroči veliko krajši čas nasičenja površine in posledično hitro samoprekinitev polovične reakcije ALD; tako skrajša čas cikla ALD. Poleg tega odlično površinsko pokritost zagotavljajo prekurzorji La amidinata na Si z vodikovimi zaključki.
Izvor: https://www.strem.com/catalog/product_blog/160/1/strem_ponudbe_novo_la-fmd{{ 7}}star_predhodnik_za_prihodnost_vodilno_edge_logiko_in{{15} }pomnilniški_izdelki
